

在半導體制造過程中,清洗工藝是極為關鍵的一步,主要用于去除硅片表面在光刻、刻蝕、離子注入、薄膜沉積等環節所殘留的顆粒、有機物、金屬離子以及天然氧化物。為達到高潔凈度標準,清洗工藝需依賴多種原材料的協同作用。這些原材料按照功能和使用方式可分為酸類、堿類、氧化劑、還原劑、有機溶劑、超純水及特種氣體等幾大類。
常見酸類原材料包括硫酸(H?SO?)、氫氟酸(HF)、鹽酸(HCl)和硝酸(HNO?)等。硫酸常與過氧化氫(H?O?)組成混合液,用于去除有機污染物和光刻膠殘留;氫氟酸用于去除硅表面上的天然氧化層,是實現裸硅表面的關鍵原料;鹽酸和硝酸則主要用于去除金屬雜質,通過絡合反應溶解金屬離子。堿類原材料以氫氧化銨(NH?OH)常用,常與過氧化氫和水組成標準清洗液(SC-1),用于去除顆粒和部分金屬雜質。
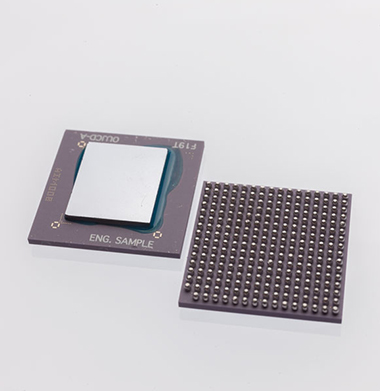
在氧化劑方面,過氧化氫(H?O?)是使用頻繁的一種,既可與酸或堿形成清洗液,又能分解為水和氧,清潔過程較為環保。還原劑如氫氣(H?)**或某些有機還原成分也用于特定的氣相或濕法還原清洗流程中,幫助去除特定類型的污染。
有機溶劑方面,異丙醇(IPA)、丙酮、甲醇和N-甲基吡咯烷酮(NMP)**等常用于光刻膠殘留物的去除。其中IPA因其揮發性好、殘留低而廣泛應用于干燥過程;NMP因其溶解能力強,多用于清洗頑固殘留。所有清洗步驟中,超純水(UPW)**都是基礎原料之一,作為稀釋液和漂洗液使用,用量大,對其純度要求也高,不含金屬離子、有機物或微粒。
此外,為配合某些干法或氣相清洗工藝,氮氣(N?)、氬氣(Ar)、臭氧(O?)、**氟化氫氣體(HF氣)**等也作為原材料投入使用。其中,臭氧常與水配合生成臭氧水,用于替代傳統強酸清洗流程,具備更強的氧化性和環境友好性。
綜上,半導體清洗工藝中的原材料種類繁多,涉及無機酸堿、有機溶劑、高純氣體及超純水等多個類別。合理組合使用這些原料,是實現高潔凈度、高良率和高可靠性的基礎,直接影響芯片制造的成品率和性能表現。